半导体物理复习
Chap1晶体结构价键模型
半导体构型
- 元素半导体
- 金刚石结构:C,Si,Ge
- 闪锌矿:III-V,II-VI族半导体
Chap2半导体的电子结构
直接带隙间接带隙
- 直接带隙:GaAs,GaN等
- 间接带隙:Si,C,Ge
禁带宽度的温度变化
E_g(T)=E_g(0K)-\frac{\alpha T^2}{\beta+T}对大多数III-V,IV,II-VI都比较有效
- 杂质浓度同样影响带宽,但是影响在1e18之前都比较小,可以忽略不记
有效质量
m^*=\frac{\hbar}{\frac{d^2E}{dk^2}}负的电子有效质量表示了运动等效正电荷的空穴
对有效质量的意义f=m^*a=-qE越小的有效质量越高的加速度,等效质量为0的材料意味着有无穷大的加速度
Chap3载流子定性描述
载流子的复合与俘获
复合
- 辐射复合:产生光子
- 无辐射复合:只产生声子
载流子寿命
\frac{1}{\tau}=\frac{1}{\tau_r}+\frac{1}{\tau_d}+\frac{1}{\tau_{Aug}}分别表示直接复合寿命,间接复合寿命,俄歇复合寿命.
寿命的倒数为复合的几率
- 直接复合:Ec与Ev的电子空穴直接复合,根据半导体的能隙不同会产生声子或者只产生光子
- 间接复合:电子和空穴在复合中心或电子/空穴陷阱进行复合,所有的间接复合均不产生光子.
- 激子复合:激发态电子与价带空穴组成的双粒子体系,体系的复合就是激子复合
- 俄歇复合:三粒子过程,一对电子空穴复合,能量传递给第三个电子/空穴.无辐射,主要发生在重掺杂当中.
Chap4载流子的定量统计描述
n_0=N_c\cdot e^{-\frac{E_c-E_F}{k_0T}},p_0=N_v\cdot e^{-\frac{E_F-E_v}{k_0T}}n_0=n_i\cdot e^{-\frac{E_F-E_i}{k_0T}},p_0=p_i\cdot e^{-\frac{E_i-E_F}{k_0T}}n_0\cdot p_0=n_i^2=N_c\cdot N_ve^{-\frac{E_g}{k_0T}} - 简并半导体:重掺杂下,Ec靠近EF,为重掺杂

电中性关系
p_0+\sum n_D^+=n_0+\sum p_A^-在这里,nD与pA指的是在杂质能级的电子和空穴
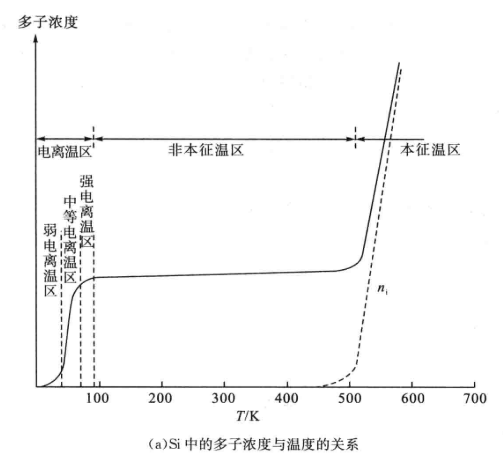
- 本征温度:达到本征温区时的临界温度
Chap5三维半导体的载流子的电输运
散射
由于内部破坏周期性势场的因素而使载流子进入杂乱无章的状态.
两次散射之间的运动才是有效的运动,考虑平均自由程. - 电离杂质散射:由于杂质电离之后形成的带电粒子,形成库伦势场,产生散射.
\tau_i \propto \frac{T^\frac{3}{2}}{N_i},N_i=N_A+N_D - 晶格振动散射

迁移率
\mu_n=\frac{\tau_n q}{m_n^*},\mu_p=\frac{\tau_p q}{m_p^*}与平均自由时间成正比
电导率
J=\sigma E\sigma_n=nq\mu_n,\sigma_p=pq\mu_p扩散运动/扩散电流
扩散运动
- 对足够厚的样品,以扩散长度指数衰减分布
- 对薄样片,线性衰减
扩散电流
J_{n}=qD_n\frac{dp}{dx},J_p=-qD_p\frac{dp}{dx}爱因斯坦关系
核心是浓度梯度形成的内建电场与电流平衡
\frac{D_n}{\mu_n}=\frac{k_0 T}{q},\frac{D_p}{\mu_p}=\frac{k_0 T}{q}Chap7 M-S接触
几个定义
- 功函数:
W_s=E_0-E_F - 电子亲合能:
\chi=E_0-E_c E_n=E_c-E_{Fs}W_s=\chi+E_n
整流接触
- n型:
W_m>W_s - p型:
W_s>W_m
肖特基势垒(n型为例)
- 半导体到金属:
qV_D=-qV_s=W_m-W_s - 金属到半导体(肖特基势垒):
q\phi_{ns}=E_g-(W_m-\chi)
电流输运
热电子发射理论
核心:势垒区很薄,势垒边缘的电子能直接穿越,此时的势垒区宽度不重要,高度成为关键.利用s到m的运输进行分析,并在零偏压的情况下计算反向电流
理查逊常数A^*=\frac{4\pi qm_n^*k_0^2}{h^3}反向饱和电流密度
J_{ST}=A^*T^2\cdot exp(-\frac{q\phi_{ns}}{k_0T})I-V特性
J_{s\to m}=J_{ST}\cdot exp(\frac{qV}{k_0T})W,J_{m\to s}=J_{ST}J=J_{ST}\cdot [exp(\frac{qV}{k_0T})-1]扩散理论
核心:当迁移率较低的时候,势垒区宽度大于平均自由程,发生碰撞
耗尽区宽度x_d=\sqrt{\frac{2\varepsilon_r\varepsilon_0(V_D-V)}{qN_D}}其他影响
- 镜像力:降低肖特基势垒,高电场反向电压下
- 隧道效应:反向偏压下,势垒降低
势垒电容(交流电容)
C=\frac{\varepsilon_0\varepsilon_r}{x_d},\frac{1}{C^2}=\frac{2}{\varepsilon_0\varepsilon_r qN_D}(V_D-V)斜率获得掺杂浓度,零点获得VD
欧姆接触
- 极低的势垒高度,热电子直接发射
- 高的掺杂浓度,隧穿效应